2.5D/3D半導体パッケージングの熱対策戦略
2025年7月15日

半導体パッケージングは、従来の1次元的(1D)PCB設計から最先端ウエハーレベルでの3Dハイブリッドボンディングへと進化しており、高エネルギー効率を維持しつつ、数マイクロメートル単位の配線ピッチと最大1000GB/秒の帯域幅を実現しています。
この変革の中心にあるのが、2.5D/3D先端半導体パッケージング技術です。この技術は、演算、メモリ、I/Oなど機能別に分割したブロックをそれぞれ最適なプロセスノードで製造し、1つのパッケージに統合するというチップレット設計の概念に基づいています。2.5Dパッケージング技術ではチップレットをインターポーザ上に並べて配置するのに対し、3Dアーキテクチャではチップレットを垂直方向に積層します。このモジュール型集積はシステムの性能向上やコスト削減を実現し、設計の柔軟性も高めます。こうした利点は、AIやHPCに求められる厳しいワークロードに対応する上で非常に重要です。
しかし、AIのワークロード増大に伴ってTDP(熱設計電力)が上昇し、パッケージングの高度化による高密度な集積化が進んでいることもあり、限られた放熱面積での熱管理が深刻な課題となっています。
本記事では、3次元(3D)積層チップに関連する電力・熱の課題だけでなく、2.5D/3Dパッケージング技術に業界が採用または提案しようとしているソリューションの最新動向についても解説します。これらの見解は、先端半導体パッケージング技術の熱管理戦略を包括的に分析した、IDTechExの調査レポート「先端半導体パッケージングの熱管理 2026-2036年:技術、市場、機会」に基づいています。
3次元積層チップの電力課題
3次元積層チップでは、電流密度増加やピン数の制約、垂直配線の採用によって、電力供給が2Dに比べて大幅に複雑化します。k層から成る3次元積層は、実装面積が同じ2次元チップの約k倍の電流を消費する一方で、電源ピンやパッケージングのリソースを相応に増やすことはできず、不均衡が生じて数多くの課題が引き起こされます。電力供給に使用されるTSVは大きな抵抗(通常はスタック当たり約1Ω)を発生させるため、IRドロップが大きくなり、安定した供給電圧を維持するのが難しくなります。一般的に、電力供給は積層全体の累積電流を流す必要のある最下層から行われるため、電圧降下や動的ノイズの影響を受けやすくなります。
多くの場合、電力を大量消費する演算ブロックはヒートシンクに近接して配置される(同じく最下層)ことから、この状況はさらに複雑さを増します。他方では、空白領域が少ないことが効果的なデカップリングの妨げとなります。というのも、TSVと高密度配線によってデカップリングコンデンサを配置できる領域が減るからです。こういった複合的な影響によって積層全体の電圧変動が大きくなり、特に最大負荷状態では、性能のばらつき、タイミングの不確実性、信頼性のリスクが高まることになります。
3次元積層チップの熱課題
熱管理は、3次元積層チップの最も重要なボトルネックの1つです。熱が水平方向やヒートシンクに向かって垂直に放散する2次元設計とは異なり、3次元積層は薄型ダイで構成されているため、水平方向への熱拡散が制限されてしまいます。加えて、ダイが中央に配置されているためにヒートシンクからの距離が長くなり、効果的な放熱経路をとりづらくなり、熱が蓄積しやすくなります。さらに、誘電体層や接着剤などの低熱伝導性ダイボンディング材料により、垂直方向の放熱経路をとるのにも制約を受けます。その結果、熱ホットスポットが発生し、リーク電流の増加やインターコネクトへの負荷による性能と信頼性の低下を招くことになります。
もう1つの大きな問題は、近接に配置された高出力ロジックブロックとメモリにより層間で非常に強い熱結合が発生し、さらに複雑化した熱設計が求められる可能性があることです。従来の冷却法では埋め込み層まで届くほど効果が高くない場合が多く、熱TSVやチップレベルのマイクロ流体冷却などの別の技術を検討する必要が生じます。一方でこうした方法は、設計の複雑さやコスト、集積の課題という点で、それぞれ特有のトレードオフを伴います。
熱伝導効率向上を実現する材料イノベーション
2.5D/3Dの半導体パッケージングにおいて、より効率的な熱管理に対応すべく、業界ではいくつかの革新的ソリューションを積極的に模索しています。注目を集めている主要分野の1つに、高度な熱伝導材料(TIM)の開発が挙げられます。IDTechExの調査レポート「先端半導体パッケージングの熱管理 2026-2036年:技術、市場、機会」では、TIM1・TIM1.5向け先進材料を中心にTIM技術を詳細に分析しています。これらの材料には、液体金属、インジウム箔、グラフェンシート、高熱伝導性銀入り次世代サーマルゲルなどが選択肢として挙げられます。
同時に、従来の2層構造TIM(TIM1、TIM2)から単層TIM1.5への移行も進んでいます。TIM1.5では、材料の界面を可能な限り減らすことで熱抵抗を低減することを目的としています。TIM1.5への移行が進むことで使用するTIMの層数は減るかもしれませんが、TIM1.5向け材料には高い技術仕様が求められるために高単価が期待でき、必ずしも市場規模の縮小につながるとは限りません。IDTechExは、先端半導体パッケージング向けのTIM1・TIM1.5の市場が、2036年までに約5億ドル規模に成長すると予測しています。
TIM以外では、ダイヤモンドが有望な研究分野として挙がっています。銅メッキを施したダイヤモンドを高性能半導体パッケージングの基板材料として使用するというものです。本レポートでは、ダイヤモンド基板の先端パッケージングアーキテクチャへの導入についても、最新動向、技術的課題、今後の展望を徹底的に解説しています。
液冷、液浸冷却、マイクロ流体冷却
材料のイノベーション以外に、水冷式アクティブ冷却も高度熱管理において重要なトレンドになりつつあります。高性能データセンターでは、すでにD2C冷却や液浸冷却などの技術が商用展開まで進んでいます。特に、昨年からNVIDIAがGB200、NVLink72でコールドプレート冷却を採用したことで、主流の短期的ソリューションとして確固たる地位を築いています。少なくとも今後2、3年間はコールドプレート冷却が有力なソリューションであることに変わりはないとIDTechExは見ています。
コールドプレート冷却と液浸冷却が、主にチップパッケージから外部に熱を放散することを目的としている一方で、より差し迫った熱対策の課題は、パッケージ自体の内部に存在しています。つまり、3Dパッケージングアーキテクチャにおいて垂直積層された部品間で発生する熱の管理です。今のところ、業界ではこの課題への明確な解決策を確立できていません。
IDTechExは、実装技術のさらなる複雑化のデメリットはあるものの、マイクロ流体冷却がパッケージ内部の熱対策のボトルネックを解消する有望な候補であると考えています。マイクロ流体冷却では、入り組んだマイクロ流路を利用してパッケージの蓋内部あるいは直接的にパッケージング構造内部に冷却水を循環させます。マイクロ流体冷却技術については、さまざまなアーキテクチャ構成の開発が進められていますが、設計と製造において複雑さが大幅に増すこと、スケーラビリティへの懸念があること、長期的信頼性に関するデータが不十分であることなど、今なおいくつかの障壁に直面しています。
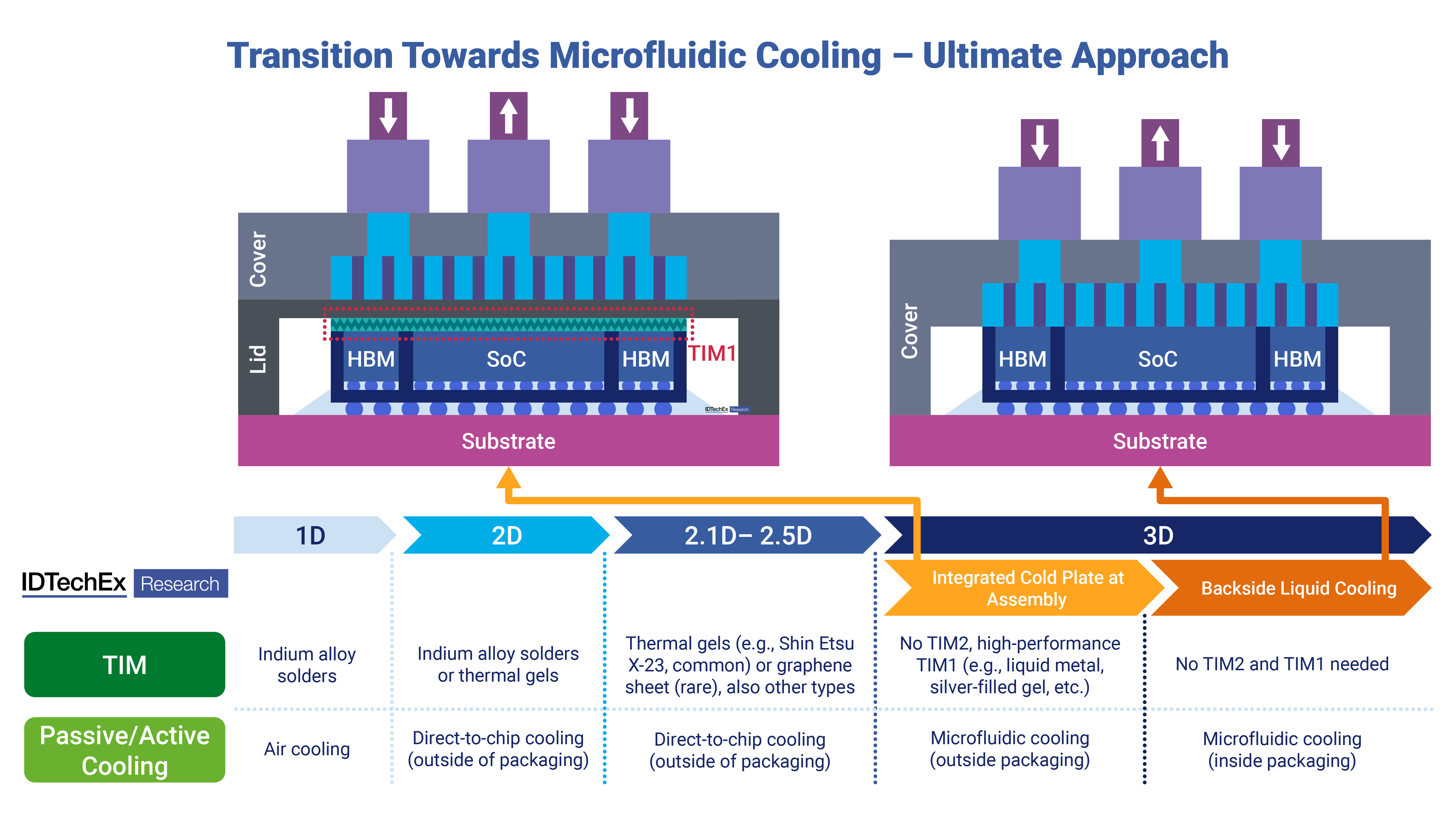
IDTechExの調査レポート「先端半導体パッケージングの熱管理 2026-2036年:技術、市場、機会」では、2.5Dから3Dへの先端半導体パッケージングの移行、電力供給方法の進化(裏面電源供給、シリコン貫通電極など)、3次元積層チップの熱対策への課題、革新的熱材料(熱伝導材料、ダイヤモンド基板など)の使用、液冷技術(D2C冷却システム、液浸冷却システム、マイクロ流体冷却システムなど)の導入について、包括的な分析を提供しています。
また、現在進行中のマイクロ流体冷却に関する研究開発状況を徹底分析し、先端半導体パッケージングでの今後の採用に向けた潜在的なアーキテクチャのロードマップを概説しています。
本レポートは以下の情報を提供します:
- 材料別(液体金属、インジウム箔、グラフェンシート、サーマルゲル)先端半導体パッケージング向けTIM1・TIM1.5の面積・市場規模予測(2026年~2036年)
- マイクロ流体冷却方式の先端半導体パッケージング数量予測(2026年~2036年)
- ハイエンドデータセンター向け半導体液冷の10年間の市場規模予測(D2C/コールドプレート冷却・液浸冷却別
さらに詳しくは、IDTechExの調査レポート「先端半導体パッケージングの熱管理 2026-2036年:技術、市場、機会」でご確認ください。該当ページからサンプルページがダウンロードできます。
About IDTechEx
IDTechExの調査レポートは、
・アイディーテックエックス株式会社 (IDTechEx日本法人) が販売しています。
・IDTechExからの直接販売により、お客様へ各種メリットを提供しています。
・ご希望の方に、サンプルページ 送付します。
・その他、調査レポートに関する、質問、購入に関する問い合わせは、
下記担当まで。見積書、請求書も発行します。
問合せ先
アイディーテックエックス株式会社
東京都千代田区丸の内1-6-2 新丸の内センタービル21階
担当:村越美和子 m.murakoshi@idtechex.com
電話 : 03-3216-7209
IDTechExは、調査、コンサルタント、サブスクリプションを通して、戦略的なビジネス上の意思決定をサポートし、先進技術からの収益を支援しています。IDTechExの調査およびコンサルティングの詳細については、IDTechExの日本法人、アイディーテックエックス株式会社まで、お問い合わせください。