先端半導体パッケージング:主要材料とプロセスのトレンド
2024年11月8日
Dr Yu-Han Chang
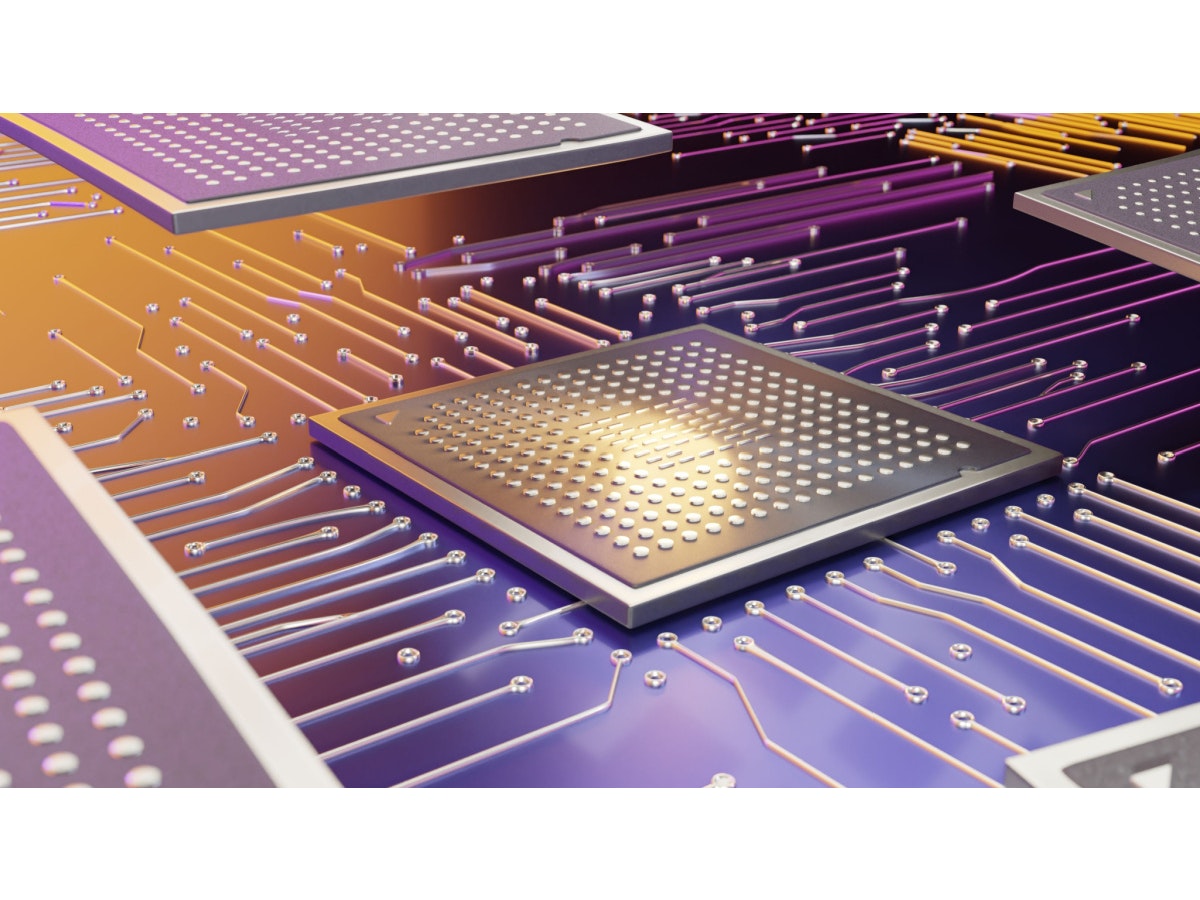
半導体パッケージング技術が進化するにつれ、より高い性能と電力効率を実現するには、2.5Dや3D Cu-Cuハイブリッドボンディングのような先進的な手法が不可欠です。しかし、これら技術の製造において顧客要求に応えつつ、性能や歩留まり基準をクリアするのは単純な話ではありません。課題としては、適切な材料の開発やパッケージング製造技術のイノベーションなどが挙げられます。IDTechExの調査レポート 「先端半導体パッケージングの材料とプロセス 2025-2035年:技術、有力企業、予測」では、これらの課題についての詳細な洞察を提供し、IDTechExの専門知識を基に作成された本レポートでは、2.5Dパッケージング材料とプロセスフローにおける主なトレンドだけでなく、3Dパッケージング向けの革新的なCu-Cuハイブリッドボンディング技術についても考察しています。また、有機誘電体先端半導体パッケージングモジュールについて、数量と面積の観点からみた10年間の市場予測も掲載しており、業界関係者に今後の展望をはかる上で有益な内容を提供しています。
2.5Dインターポーザ材料
2.5Dパッケージングでは、各種チップレットがインターポーザによって水平に配線接続され、そのインターポーザの主な材料としてシリコン(Si)、有機、ガラスという3つが検討されています。微細な配線に対応できることから、シリコンインターポーザはハイパフォーマンスコンピューティング(HPC)の業界標準となっていますが、コスト高やパッケージング面積の制約が課題です。これらの解決策としては、局所的なシリコンブリッジが浮上しています。有機インターポーザは、特にFOPLP(ファンアウトパネルレベルパッケージング)の場合にコスト効率の高い選択肢となり、面積利用率を高め、コストを最大60%引き下げられます。しかし、シリコンと同等の微細な配線を実現するのはまだ難しい状況です。CTE(熱膨張係数)を調整可能で寸法安定性も高いことから、ガラスインターポーザもパネルレベルパッケージングに対応し、コスト引き下げを後押しします。とはいえ、その期待とは裏腹に、ガラスインターポーザの生産はまだ成熟過程にあり、大規模導入も限られています。エコシステムの進化に伴い、どの材料にも2.5Dパッケージングでの強みと課題が生まれ、性能とコストのバランスを取ることが焦点となっています。

インターポーザ向け材料のベンチマーク. 出典:IDTechEx調査レポート 「先端半導体パッケージングの材料とプロセス 2025-2035年:技術、有力企業、予測」
2.5D半導体パッケージングのインターポーザ用次世代材料を選定する際、一般的にDk(誘電率)、破断伸び率、CTE(熱膨張係数)、ヤング率、吸湿性という5つの主要基準が重要です。Dkが低いことは、静電容量を下げ、データレートの向上を実現する上で不可欠であり、それによりシグナル・インテグリティも向上します。破断伸び率が高ければ、材料が製造工程で受ける機械的応力に耐えられるようになります。誘電体のCTEを銅層と一致させれば、パッケージの信頼性が向上します。一方で、ヤング率も重要な要素です。ヤング率が低ければマイクロビアにかかる応力が最小限に抑えられる(ビアのサイズが5µm未満の先進設計には不可欠)一方で、ヤング率が上がるとパッケージの安定性が向上します。したがって、この対立する要件の間で適正な均衡点を見いだすことが先端パッケージングにとって極めて重要です。最後は吸湿性です。過度の湿気は層間剥離を引き起こし、機械的性能と電気的性能の双方を低下させる恐れがあり、吸湿性が低いことは長期的な信頼性にとって必須です。これらパラメータのバランスを取ることが、次世代インターポーザ材料の帯域幅と電力効率を最適化する上で極めて重要です。
Cu-Cuハイブリッドボンディングの製造
W2W(ウエハー・トゥ・ウエハー)ハイブリッドボンディングとD2W(ダイ・トゥ・ウエハー)ハイブリッドボンディングの2つは、3Dハイブリッドボンディングの主要手法であり、それぞれ明白な利点と課題があります。D2Wよりも確立されたプロセスであるW2Wボンディングでは、一般的に1回の均一な工程で2枚のウエハー全体をボンディングします。この手法には、接合面積が一定でありアライメントとボンディングが比較的簡単明瞭になるという利点があります。ウエハーが常に円形を維持しているため、このプロセスは高いスループットに最適化することができ、大規模生産に適しています。しかし、W2Wボンディングは異なるチップサイズを扱う融通性が低く、同一のウエハーをボンディングするという制約もあります。
一方で、D2Wハイブリッドボンディングはより複雑ですが、サイズの異なる高性能ダイを扱う際にW2Wが受ける制約にも対応しています。D2Wでは、ウエハーを1枚ずつボンディングする代わりに、個々のダイを対象のウエハー上に精密にボンディングするので、サイズや種類の異なるダイを1つのパッケージに集積することができます。このような融通性から、D2Wボンディングはチップレット集積などの先端パッケージング技術に最適であり、D2Wボンディングを用いることで、メーカーは機能の異なるダイをうまく組み合わせることができます。ただし、D2Wは製造上の重大な課題を抱えています。汚染や位置ずれがあると不良が発生し、ボンディングの品質が大きく損なわれる恐れがあり、D2Wでは超清浄で粒子のない表面と精密なアライメントが要求されます。
また、D2Wボンディングでは、ダイのアスペクト比を巡る問題も生じます。ダイのアスペクト比が高くなると、片側だけが接合されるという不具合が発生する恐れがあります。これは、接合が片側から始まってしまう状態であり、スケーリング効果につながる可能性があります。ダイシング中にフレキシブルな有機担体や接着剤を使用すると、プロセスはいっそう複雑になります。さらには、D2Wボンディングの方が待ち時間の影響を受けやすくなり、そのためボンディングに入る前に表面品質が低下する恐れもあります。
こうした課題はあるものの、D2Wボンディングの融通性と精密性は高性能用途にとってますます不可欠なものとなっており、同時にこれらの障壁の多くに対応するための統合ハイブリッドボンディングツールも登場してきています。

Cu-Cuハイブリッド接合の3つの方法. 出典:IDTechEx調査レポート 「先端半導体パッケージングの材料とプロセス 2025-2035年:技術、有力企業、予測」
材料とプロセスにおける技術動向
IDTechEx調査レポート「先端半導体パッケージングの材料とプロセス 2025-2035年:技術、有力企業、予測」では、まず、急成長を遂げている先端半導体パッケージング分野について紹介しています。それは後半部分での先端半導体パッケージングに不可欠な技術の詳細解説への基礎固め的な内容となっています。
次章では、先端半導体パッケージングにおける性能評価の重要性を取り上げ、製造プロセスや材料がパッケージングの全般的な有効性に与える直接的な影響について解説します。本章では、RDL(再配線層)・マイクロビア用の誘電材料(シリコン、ガラスなどの無機材料と有機材料の双方)、RDL製造技術、EMC(エポキシモールディングコンパウンド)・MUF(モールドアンダーフィル)用材料の選定といった不可欠な材料と技術に焦点を当てながら、2.5Dパッケージングのプロセスフローを具体的に解説します。本章の各サブセクションでは、製造のプロセスフロー、技術のベンチマーク、プレーヤー評価、今後の技術トレンドの特定の各項目を包括的に分析しています。
次章では、2.5Dパッケージングから、3Dダイスタッキングのための先駆的なCu-Cuハイブリッドボンディング技術に焦点を移します。当セクションでは、最善の結果を得る材料選定の指針になるように、Cu-Cuハイブリッドボンディングの製造プロセスとボンディング装置に関する有益な分析を提供しています。また本章には、魅力的な事例紹介も掲載し、有機誘電体と無機誘電体の双方を使用したCu-Cuハイブリッドボンディングの導入成功例をご紹介します。
市場予測
本レポートでは、数量と面積の両方の数値指標で予測した有機誘電体先端半導体パッケージングモジュールの10年間の市場予測を提供します。今後10年間に予想される市場の成長と動向についての洞察を得ることができます。
About IDTechEx
IDTechExの調査レポートは、
・アイディーテックエックス株式会社 (IDTechEx日本法人) が販売しています。
・IDTechExからの直接販売により、お客様へ各種メリットを提供しています。
・ご希望の方に、サンプルページ 送付します。
・その他、調査レポートに関する、質問、購入に関する問い合わせは、
下記担当まで。見積書、請求書も発行します。
問合せ先
アイディーテックエックス株式会社
東京都千代田区丸の内1-6-2 新丸の内センタービル21階
担当:村越美和子 m.murakoshi@idtechex.com
電話 : 03-3216-7209
IDTechExは、調査、コンサルタント、サブスクリプションを通して、戦略的なビジネス上の意思決定をサポートし、先進技術からの収益を支援しています。IDTechExの調査およびコンサルティングの詳細については、IDTechExの日本法人、アイディーテックエックス株式会社まで、お問い合わせください。